常用的3D OM 與最近聽到的IR OM有什麼差異? 適用於什麼情況分析?
A53D-OM (3D Optical microscope)具有大景深、傾斜角度及長工作距離的檢測優勢,可針對各種不同聚焦高度的待測物體,如圖一,進行多角度的全面對焦,並獲得全面清晰的影像進行觀察。應用領域適合進行PCB板上零件/IC封裝打線/BGAsolder ball檢測與故障分析。
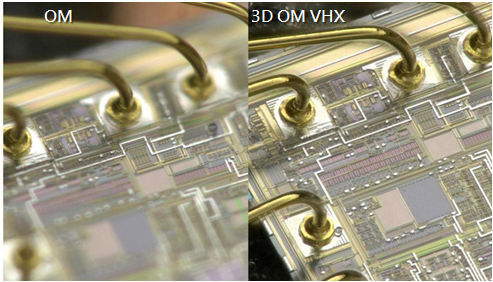
Fig. 1 可針對各種不同聚焦高度的待測物體,進行多角度的全面對焦,並獲得全面清晰的影像進行觀察
IR-OM(Infrared Microscope)的光源使用可以穿透矽材料的NIR(近紅外線),可穿透達650um的矽基板,參考圖2.因此可應用於背向EMMI/OBIRCH檢測, MEMS失效分析,矽基板器件失效分析(burnout marks,alignment in thinly bonded circuits, defects in materials ),圖3是IR OM在MEMS產品上的分析應用.
.png)
Fig. 2 可穿透Silicon的IR波長範圍在1-10um; IR-OM 的光源使用可以穿透矽材料的NIR(近紅外線, 700nm-1500nm),可穿透達650um的矽基板.
.png)
Fig. 3 IR-OM應用於MEMS的失效分析,可檢視未破壞前MEMS的內部結構及缺陷
(工程總處-失效分析Team)
