蔚博士檢測專欄:IC缺货,假IC流通 DPA提前識別攔截 幫您把關
新冠疫情爆發後,“晶片荒” 在去年年底首先衝擊了汽車製造商,後續遠距會議/授課的必要性,電腦、智慧型手機等消費型電子產品需求暴增,晶片需求同步上升。產量追不上需求,導致全球晶片短缺。根據國際研究暨顧問機構Gartner預估,晶片短缺的情況會持續到2022年。近期新聞報導不斷,晶片供不應求,一不小心就買到假晶片。怕用到劣質晶片衝擊自家產品功能與形象,公司如何加強真偽測試,力求自保。
常見的假晶片有兩類。第一類是沒有功能的空白晶片;另一類是品質不良的次級品如回收廢棄的晶片並移除商標,重新包裝出售或將一般產線上的淘汰品包裝為優質產品出售。這些假晶片在性能、可靠度和耐久度自然不如一般晶片,在第一時間或經過一段時間問題就會浮現。
如何加強真偽測試,力求自保
在晶片短缺舒緩前,假貨恐怕仍會存在,許多公司為了規避假貨的潛在風險,自行提高檢測能力,購買檢測假貨X光機。但X光機只是能檢查上述第一類沒有功能的空晶片,對於品質不良的次級品沒有檢出能力,必須要搭配其他方式,從驗證元器件的設計、結構、材料和製造品質來驗傷;就是所謂的DPA方式。
DPA是什麼?-可以確保產品結構品質上有無異常
破壞性物理分析(Destructive Physical Analysis)簡稱為DPA
是為了檢驗元件的設計、結構、材料和製造質量是否满足預定用途或有關規範的要求
① 確保產品在出貨前或是可靠性驗證後,結構質量有誤一場
② 按元器件的生產批次進行抽樣檢測
③ 對元器件樣品進行非破壞性分析和破壞性分析裡的一系列檢測。
DPA的目的_早期發現 糾出缺陷
DPA分析技術可以快速發現潛在的材料、工藝等方面的缺陷,這些缺陷最終導致元器件失效的時間是不確定的,多數為早期失效,但所引發的後果是嚴重的。
電子元器件進行DPA的關鍵節點
1.器件選型,選擇不同供應商,同類產品橫向比對;
2.在訂貨合同中提出DPA要求,即生產廠家供貨時必須提供DPA合格的報告;
3.元器件到貨後,上機前進行來料DPA確認(例行抽檢) ;
4.器件可靠性風險提前識別,可靠性試驗之後進行DPA確認。
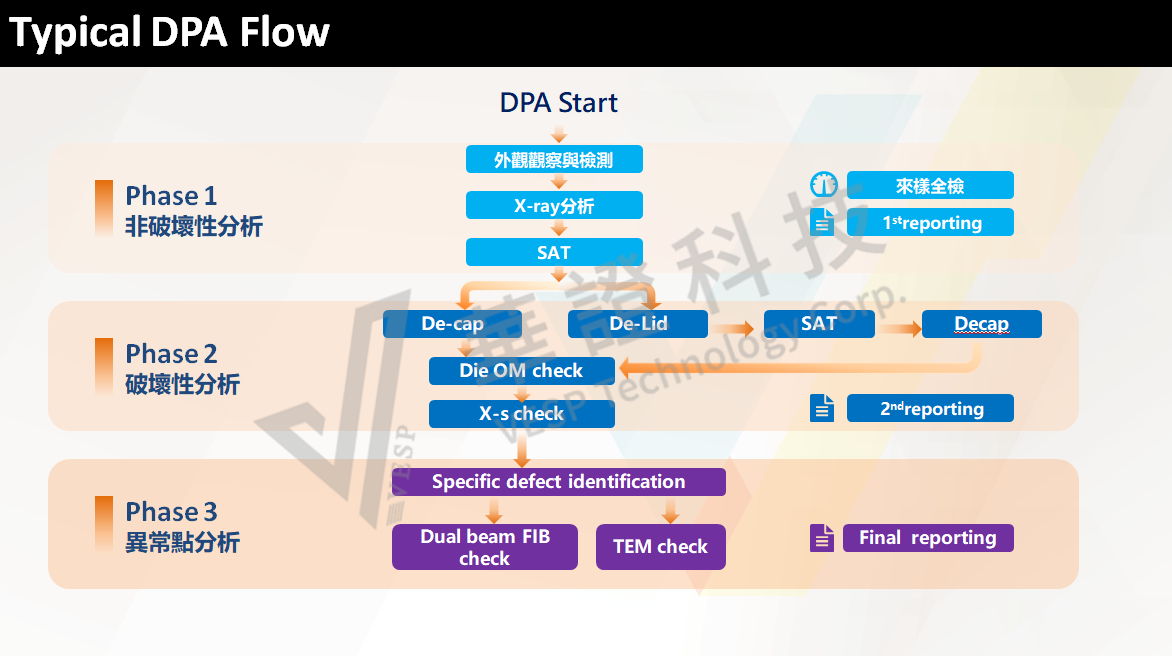
鍵合與粘貼打線對齊不良及短路或開路_ X-光機
封裝分層及孔洞檢查_超聲波掃描
樣品內部結構/尺寸剖析
樣品內部缺陷剖析
樣品成分定性定量分析
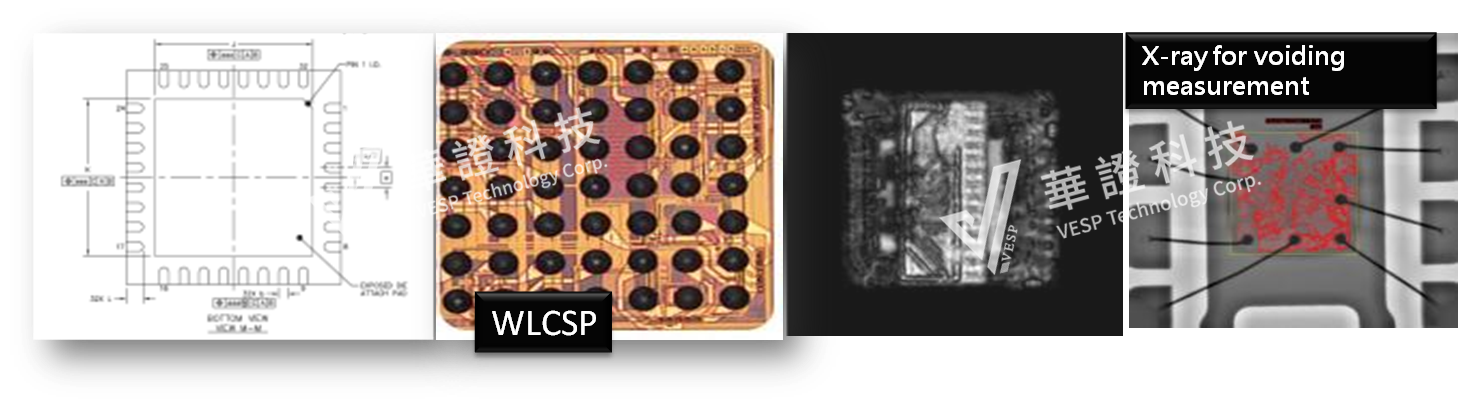
真假晶片確認
鍵合類型 /晶片尺寸/劃片道觀察
晶片標記/晶片外貌
鍵合球球徑/鍵合絲直徑

測量晶片厚度
晶片劃片尺寸測量
銀膠爬升高度
鍵合球工藝觀察鍵合線材質確認

為客户量身定做的DPA方案_值得收藏
各種封裝結構不同,因此單一DPA方案不完全適用所有型式的封裝。我們整理了幾種主要的封裝類型,運用3D-X-ray、金相切片、迭層晶片分離、晶片內部檢查等關鍵技術,提出了一系列適用性強、效率高的破壞性物理分析方案,包括WLCSP WB-BGAWB-BGAWB-Leadframe做為客戶的選擇。其他還有更多的先進封裝DPA方案,歡迎諮詢。



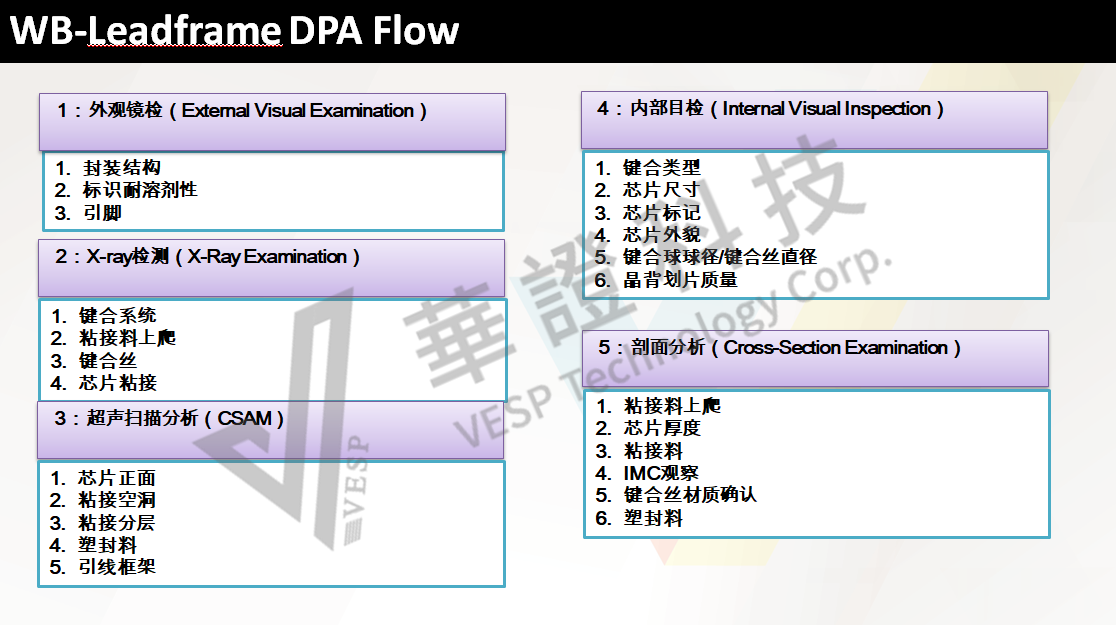
本文作者:華證科技工程總監 陈志榮 博士